英特尔引入了一些包装技术突破,包括HBM4和UCI
作者:365bet体育投注 发布时间:2025-06-06 14:17
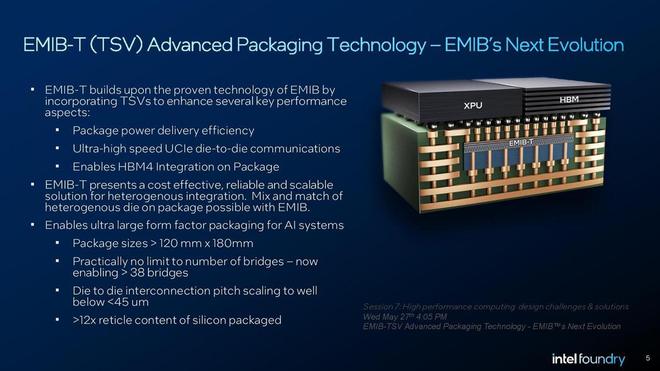 最近,英特尔电子组件技术会议(ECTC)引入了许多包装技术突破,并概述了各种新的芯片包装技术的好处。有三种新的包装技术值得关注,包括:EMIB-T,用于增加芯片包装和电动供应的大小,以支持HBM4/4E等新技术;新的分散散热器设计;以及一种新的热结合技术,可提高可靠性和产量,并支持更精致的片间连接。英特尔铸造厂的目标是使用节点切割技术为内部和外部公司生产芯片。尽管处理器进一步采用了复杂的异质设计,但将许多类型的计算和存储器组件纳入单个芯片包装,从而提高了性能,成本和能源效率,但它取决于复杂的高级包装技术。 EMIB-T可以提高电源效率的关键指标和S片间交流。常见的EMIB连接由于悬臂供应路径而引起的高压塌陷问题,而EMIB-T则由硅(TSV)通过TSV桥芯片从芯片封装的底部进行动力,该桥芯片可实现直接,低阻力路径,这对于HBM4/4E集成至关重要。同时,使用UCIE-A互连技术将数据传输速率提高到32 GB/s或更高,TSV还改善了芯片之间的通信带宽。 EMIB-T还允许更多的Malarge芯片包装尺寸,最大120 x 180毫米,并在一个大型芯片包装中支撑38多个桥梁和12个以上的矩形。 EMIB-T可以支持35微米的凸起,并且正在开发25微米,这比第一代EMIB的55微米和第二代EMIB的45微米要好。此外,EMIB-T还与有机或玻璃基板兼容,其中玻璃基板是主要的战略方向OF英特尔的未来芯片包装。英特尔还宣布了一种新的分解散热器技术,该技术将散热器和钢筋肋骨上的散热器摧毁,以改善位于散热器和底层芯片之间的散热器和热接口材料(TIM)之间的耦合,还有助于减少TIM中的差距,使Tim的间隙减少25%。 Nintel显示了具有集成微通道的散热器,其流体直接通过IHS处理器冷却,该处理器支持TDP高达1000W的处理器包装。英特尔在消费者服务器和产品上都采用了热媒体键合技术,现在已经针对大型包装基板开发了新的热压键合工艺,有助于克服粘结期间的芯片和底物翘曲,最小化包装底物,芯片和芯片之间的热差,并在可靠性指示器指示下,并实现了比当前大型制造商更大的芯片套餐。技术还允许更精细的EMIB连接距离间距,这有助于挤压EMIB-T的密度增加。 【来源:超级电力网络】
最近,英特尔电子组件技术会议(ECTC)引入了许多包装技术突破,并概述了各种新的芯片包装技术的好处。有三种新的包装技术值得关注,包括:EMIB-T,用于增加芯片包装和电动供应的大小,以支持HBM4/4E等新技术;新的分散散热器设计;以及一种新的热结合技术,可提高可靠性和产量,并支持更精致的片间连接。英特尔铸造厂的目标是使用节点切割技术为内部和外部公司生产芯片。尽管处理器进一步采用了复杂的异质设计,但将许多类型的计算和存储器组件纳入单个芯片包装,从而提高了性能,成本和能源效率,但它取决于复杂的高级包装技术。 EMIB-T可以提高电源效率的关键指标和S片间交流。常见的EMIB连接由于悬臂供应路径而引起的高压塌陷问题,而EMIB-T则由硅(TSV)通过TSV桥芯片从芯片封装的底部进行动力,该桥芯片可实现直接,低阻力路径,这对于HBM4/4E集成至关重要。同时,使用UCIE-A互连技术将数据传输速率提高到32 GB/s或更高,TSV还改善了芯片之间的通信带宽。 EMIB-T还允许更多的Malarge芯片包装尺寸,最大120 x 180毫米,并在一个大型芯片包装中支撑38多个桥梁和12个以上的矩形。 EMIB-T可以支持35微米的凸起,并且正在开发25微米,这比第一代EMIB的55微米和第二代EMIB的45微米要好。此外,EMIB-T还与有机或玻璃基板兼容,其中玻璃基板是主要的战略方向OF英特尔的未来芯片包装。英特尔还宣布了一种新的分解散热器技术,该技术将散热器和钢筋肋骨上的散热器摧毁,以改善位于散热器和底层芯片之间的散热器和热接口材料(TIM)之间的耦合,还有助于减少TIM中的差距,使Tim的间隙减少25%。 Nintel显示了具有集成微通道的散热器,其流体直接通过IHS处理器冷却,该处理器支持TDP高达1000W的处理器包装。英特尔在消费者服务器和产品上都采用了热媒体键合技术,现在已经针对大型包装基板开发了新的热压键合工艺,有助于克服粘结期间的芯片和底物翘曲,最小化包装底物,芯片和芯片之间的热差,并在可靠性指示器指示下,并实现了比当前大型制造商更大的芯片套餐。技术还允许更精细的EMIB连接距离间距,这有助于挤压EMIB-T的密度增加。 【来源:超级电力网络】 
